製品情報
製造向け多層成膜用装置
AFTEX-8000シリーズ
複数の材料の多層膜が成膜可能な固体ソース ECR プラズマ成膜装置。 1つの成膜室にECRプラズマ源を2基搭載し、最大8インチ径の基板上に、均一性に優れた多層膜を形成できる全自動装置、基板に対するプラズマダメージの少ない成膜が可能です。
- 低温プロセス
- 高屈折率制御
- 高速反応性成膜
- 撤密 ・平坦膜
AFTEX-8000シリーズは、1つの成膜室に傾斜配置したECRプラズマ源を2基搭載し、高品質な光学薄膜などを最大8インチ径の基板上に均一性に優れた多層膜を形成できる、C to C枚葉式全自動多層膜形成装置です。高活性・高密度ECR(Electron Cyclotron Resonance)プラズマ源を用い、プラズマ引き出し部にターゲットを配置することによって固体ソースによるECRプラズマ成膜を実現しています。CVDのような危険なガスを用いる必要がないため排ガス処理の必要もなく、地球環境に優しい成膜技術です。
- 成膜特性
- 製品の特徴
- 標準仕様
- ECRプラズマ成膜の原理と特徴
固体ソースECRプラズマ成膜は、低圧で高密度のECRプラズマ流と、プラズマ流の出口に配置した固体ソース(ターゲット)からのスパッタ粒子を直接反応させるため、次の特徴的な膜質が期待できます。
高品質薄膜形成
10-30eVの低エネルギーに制御された高密度イオンの照射下で薄膜が成長するため、原子レベルの平滑性を持つ緻密・高品質な薄膜が形成されます。例えばSiO2成膜では、耐圧10MV/cm、光学消衰係数0.0001という最高水準の性能が、基板を加熱せず低温で実現できます。
さまざまな膜種による多層成膜
スパッタターゲットが製作可能なすべての固体材料を原料とすることができ、酸素や窒素などの導入ガスとの組み合わせにより、各種の化合物薄膜を容易に形成できます。例えば、固体ソースとしてSiを用いればSi、SiO2、Si3N4、Alを用いればAl2O3、AlN膜が形成されます。その他、Ta2O5、HfO2、ZrO2のほか、ITO、STO膜などの成膜に対応可能です。
低温・低ダメージ
イオンアシスト効果により、高温加熱を行うことなく酸化膜、窒化膜などの化合物薄膜を形成できるほか、低温で高い結晶性薄膜を得ることも可能です。また、イオンエネルギーが低いことから、基板に対して低ダメージでソフトな清浄効果を期待できます。
- 1つの成膜室にECRプラズマ源を2基搭載
- C to C枚葉式全自動処理
- (試料サイズ最大8インチ、膜厚分布±3%以下)
- アップデポジション、フェイスダウン搬送機構
- パソコンによる容易な操作、多彩なログ、コンフィグ機能
- SECS/GEM、CEマーク/UL対応 (オプション)
| 項目 | 仕様 |
|---|---|
| 到達圧力 | プロセスモジュール: < 3×10-5Pa トランスファー室: < 3×10-4Pa ロードロック室: < 3×10-4Pa |
| 真空排気系 | プロセスモジュール: ターボ分子ポンプ 1300L/sec ドライポンプ: 600L/min トランスファー室: TMP 820L/sec ドライポンプ: 500L/min ロードロック室: TMP 350L/sec ドライポンプ: 250L/min |
| ロードロック室 | 手動扉: 1式 カセットエレベータ機構: 1式 試料検出機構:1式 |
| トランスファー室 | 真空搬送ロボット:1式 試料検出機構:1式 フェイスダウン搬送方式 |
| 成膜室 | |
| 基板サイズ | Max. 8インチ |
| 基板ホルダー | 試料台回転、上下機構:1式 試料仮受台:1式 |
| 成膜方向 | アップデポジション |
| 基板加熱 | 最大300℃ |
| ECRスバッタ源 | |
| 数量 | 2式 |
| プラズマ室 | マイクロ波分岐結合型ECRプラズマ源、 基板ホルダーに対し傾斜配置 |
| マグネットコイル | 2分割式 |
| ターゲット | 円筒型(水冷方式) |
| 付属機構 | コイル傾斜機構 |
| ガス導入系 | マスフローコントローラ:3口x3式 ガス種:アルゴン、酸素、窒素 |
| 操作 | 排気、搬送、成膜はレシピ管理によるC to C全自動処理 |
| 制御系 | マイクロ波電源2.45GHz、1kW:1式 マイクロ波オートチューナー:2式 コイル電源DC1 5kW:2式 スパッタ電源:13.56MHz、1kW:1式 自動RFマッチングボックス、コントローラ:1式 シーケンサー、コンピュータ:1式 |
| 設置条件 | |
| スペース | 約5.7×4.3m (作業スペース含む) |
| 電力 | 3相 200VAC, 35KVA |
| 冷却水 | 0.3~0.4MPa, 30L/min, 4 系統 |
| 重量 | 約2600kg |
ECRプラズマ生成の原理

高屈折率制御
- 無電力、低ガス圧(0.01-0.2Pa)、高密度(5-10mA/cm²)
- 基板表面への低エネルギー(10-30eV)大電流のイオン照射効果→無加熱、低ダメージで、緻密、平滑、高品質薄膜を形成
ECR 薄膜の物性
平滑性

硬さ
SiN膜、カーボン膜はダイヤモンド並みの硬さ。厳密さ
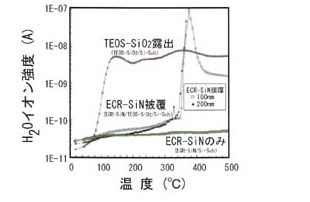
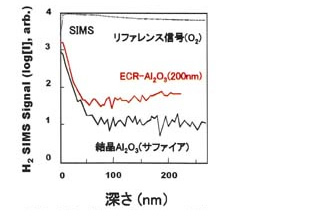
優れた光学特性
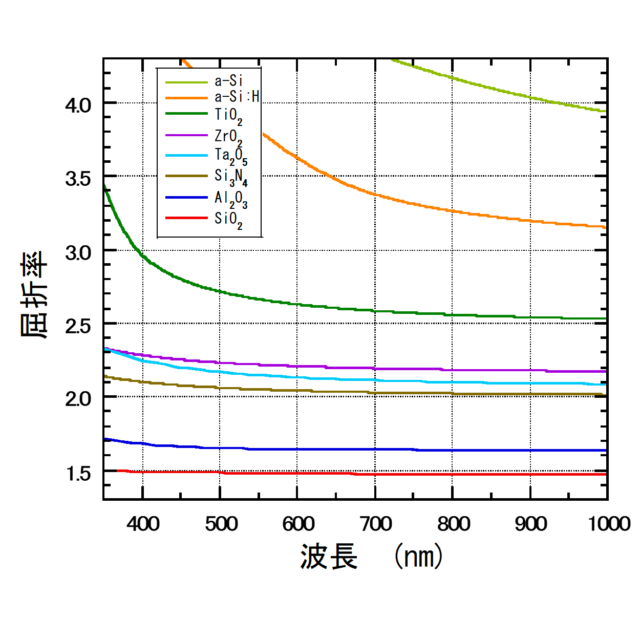
不純物フリー
高純度ターゲットとガスを原料とし、反応生成物(H、F、CIなど)無く、高純度。高配合性
AIN膜、MgO膜などの配向性。低抵抗TiN膜、α-Ta膜。被膜性
低ガス圧、高イオン化率、傾斜回転成膜により、一般のスパッタよりも段差被覆性が高い。高耐圧
バルク並みの高耐圧絶縁膜。SiO2、Al2O3膜などは10MV/cm(1000℃熱酸化膜並み)。低損傷