製品情報
実験・開発向け装置
AFTEX-2300
超薄膜研究・開発用固体ソースECRプラズマ成膜装置。 固体ソース ECR プラズマ成膜装置の基本機能のみを装備した装置ですので自動成膜装置にくらべて価格を抑えてあります。
- 低温プロセス
- 低ダメージ
- 撤密 ・平坦膜
- 高屈折率制御
薄膜研究にたずさわる方々からの強い要望にお応えするため、お求めやすい価格のAFTEX-2300を開発いたしました。低価格ながらマイクロ波分岐結合型ECRイオン源を搭載するとともに、 ロードロック機構、ターボ分子ポンプを装備した高性能機です。 酸化物、窒化物などの薄膜研究に最適な装置です。
- 成膜特製
- 製品の特徴
- 標準仕様
- ECRプラズマ成膜の原理と特徴
成膜特製
高品質薄膜形成
10-30eVの低エネルギーに制御された高密度イオンの照射下で薄膜が成長するため、原子レベルの平滑性で緻密・高品質な薄膜が形成されます。10MV/cmの極限的な耐圧を示すSiO2膜のほか、ダイヤモンド並みに硬く、水分の遮断性に優れたSi3N4、水素バリア性の高いAI2O3などが得られます。
低温・低損傷
イオンアシスト効果により、高温の加熱を行うことなく酸化膜、窒化膜などの化合物薄膜を形成できるほか、低温で高い結晶性薄膜を得ることも可能です。また、イオンエネルギーが低いことから、基板に対して低損傷でソフトな清浄効果を期待できます。
高反応性成膜
スパッタターゲットが製作可能なあらゆる固体材料を原料とし、酸素や窒素などの導入ガスとの組み合わせにより、各種の化合物薄膜を容易に形成できます。例えば、固体ソースとしてSiを用いればSi、SiO2、Si3N4膜、AIを用いればAI2O3、AIN膜が形成されます。その他、Ta2O5、HfO2、ZrO2ほか、ITO、STO膜などの実績があります。
製品の特徴
- マイクロ波導入窓への膜付着を防ぎ、長期安定稼働を実現した分岐結合型ECRプラズマ源搭載
- 固体ソースからのスパッタ粒子と低エネルギー・大電流のECRプラズマ流(酸素、窒素等)を直接反応させるため、排ガス処理不要の環境適応装置
- 成膜室の主排気はターボ分子ポンプを採用するとともに、ロードロック機構の採用によりクリーンな成膜環境を実現
- 真空排気はシーケンスが自動化され、各種インターロック機構採用
標準仕様
| 項目 | 仕様 |
|---|---|
| 真空排気系 | 成膜室:TMP(450 l/s) ロードロック室:RP(250 l/min)TMP兼用n |
| 成膜室 | |
| チャンバ寸法 | φ570x340mmm |
| 基板サイズ | φ4インチ |
| 基板加熱 | オプション |
| ターゲット基板間距離 | 200mm |
| ロードロック室 | |
| 搬送方式 | トランスファーロッド |
| 収納数 | 1枚 |
| ECRプラズマ源 | |
| 数量 | 1式(μ波分岐結合型) |
| プラズマチャンバ | φ150mm |
| 円筒ターゲット部 | φ100x40mm |
| ガス導入系 | 2系統 |
| 制御電源 | マイクロ波電源2.45GHz、1kW:1式 コイル電源DC 1.5kW:2台 ターゲット電源:1台(RF13.56MHz) |
| 操作 | |
| 排気 | 自動 |
| 基板搬送 | 自動 |
| 成膜 | 自動 |
| 外形寸法 | 1.8×1m |
| オプション | DCスパッタ 加熱基板 基板バイアス ガス導入1追加可 μ波オートチューナー |
| 性能 | |
| 真空 到達圧力 | 10¯5Pa台 |
| 成膜 膜厚分布 | φ3インチ±10% |
| 設置条件 | |
| 電力 | 3φ AC200V 20KVA |
| 冷却水 | 10 l/min 0.3MPa |
| 重量 | 1000kg |
ECRプラズマ成膜の原理と特徴
ECRプラズマ生成の原理

磁界強度87.5mT(テスラ)の磁力線の周りを回転する電子は、2.45GHzの交流電界で共振し(Electron Cyclotron Resonance、電子サイクロトロン共鳴)、エネルギーを受け取って高速回転します。このため、放電が難しい低圧でもガス分子との衝突が起こり、効率よくプラズマが発生します。
高屈折率制御
- 無電力、低ガス圧(0.01-0.2Pa)、高密度(5-10mA/cm²)
- 基板表面への低エネルギー(10-30eV)大電流のイオン照射効果→無加熱、低ダメージで、緻密、平滑、高品質薄膜を形成
ECR 薄膜の物性
平滑性

原子1個レベルの僅かな凹凸。(Al2O3膜のRmax = 0.48nm @ 膜厚100nm)
硬さ
SiN膜、カーボン膜はダイヤモンド並みの硬さ。厳密さ
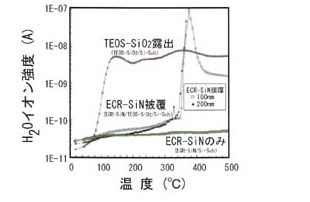
SiN膜の弗酸耐性はPECVD膜の10倍。水分や水素に対しても高いバリア性。SiN膜の水遮断特性(SiN膜被覆で確実に阻止)
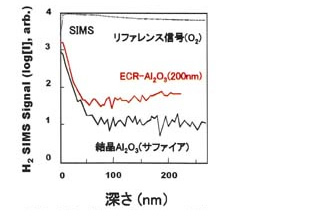
Al2O3膜の水素バリア特性(バルク並みのバリア性)
優れた光学特性
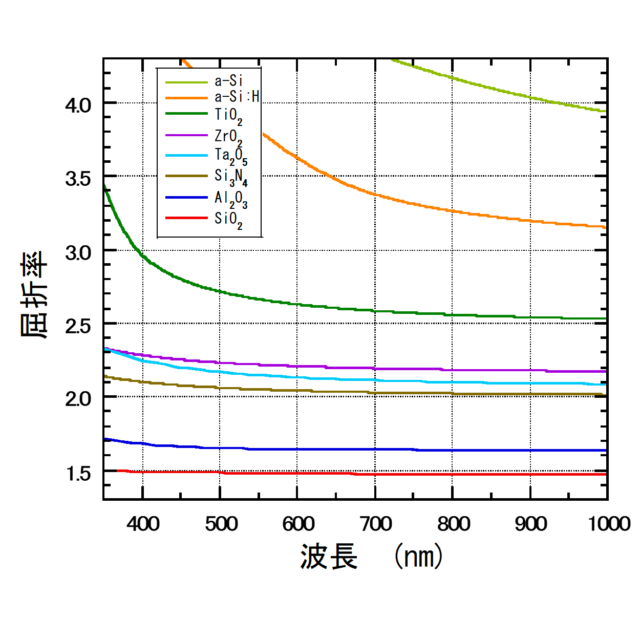
高精度な屈折率制御。高い光透過性。(SiO2、SiN、AI2O3、AlN、Ta2O5、ZrO₂など)
不純物フリー
高純度ターゲットとガスを原料とし、反応生成物(H、F、CIなど)無く、高純度。高配合性
AIN膜、MgO膜などの配向性。低抵抗TiN膜、α-Ta膜。被膜性
低ガス圧、高イオン化率、傾斜回転成膜により、一般のスパッタよりも段差被覆性が高い。高耐圧
バルク並みの高耐圧絶縁膜。SiO2、Al2O3膜などは10MV/cm(1000℃熱酸化膜並み)。低損傷
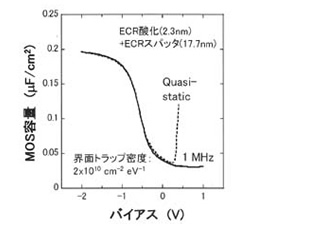
ECR-SiO₂膜を用いたMOSキャパシタの C-V特性(無加熱ECR酸化で優れた界面特性を実現)MOSキャパシタの界面準位、界面電荷が小さい。